第三代半导体---碳化硅
第三代半导体---碳化硅
地球上几乎所有的能源都能转换成电力,而电能用于特定目的都需要功率调节和转换,目前主要调节功率的效率是由半导体器件性能所决定。

功率半导体主要用于电力设备的电能转换和电路控制,是进行电能处理的核心器件。包括变频、变压、变流、功率放大和功率管理,除了保证设备正常运行,还能起到有效节能作用。

美国通用公司研制出世界上第一个工业用的普通晶闸管,也使硅Si走到人们面前。但是近年来,随着技术生产的进步,硅固有的材料特性在某些领域几乎达到了理论极限,例如,高阻断电压600V以上功率器件的应用难题,即使在今天技术都很成熟的情况下,都不容易突破,由此可见,研发替代硅的新材料迫在眉睫。
90年代,新出现的碳化硅SiC,氮化镓GaN,引起了科学家的希望。

因为出色的物理性能和成熟的工艺技术,还有与硅基材料加工工艺的极大的兼容性,让碳化硅在同类宽禁带半导体胜出。以最开始商用的4H-SiC肖特基二极管为例,其导通电阻比同类硅器件低两个数量级。在同功率的等级下,碳化硅模块体积明显小于硅模块。碳化硅已经从生活中4C产业提升电能利用效率,到新能源车提高单次充电续航里程,还有光伏逆变器电能转换率,甚至大功率领域的高压直流输电系统里处处可见了。
自然界的碳化硅,又叫金刚砂,存在于岩石中。作为晶体材料于1892年通过碳和二氧化硅在1950℃的高温下放热得到。后续经美国工程师的不断改良,才得到能用于晶体生长的高纯碳化硅。直到现在逐步发展到了直径为100-200mm的碳化硅晶体的生长。
目前,碳化硅还有很多瓶颈。比如,因为技术的垄断,造价非常高。其次封装大电流、功率器件的散热问题和生长中缺陷导致的可靠性问题有待进一步突破。
碳化硅的主要生长方法:
碳化硅材料是个大家族,所有的成员从化学组成比例角度看,都是一样的,50%的碳原子和50%的硅原子。随着结构之间的连接方式发生变化,就构成了晶体结构的多型。目前被确认的碳化硅晶体有250多种。
1、 籽晶升华生长
基本原理是碳化硅粉料在高温和低压下升华产生的主要气相物质(Si,Si2C,SiC2),随着温度梯度的下降沉积在温度稍低的籽晶上,并在其上结晶。
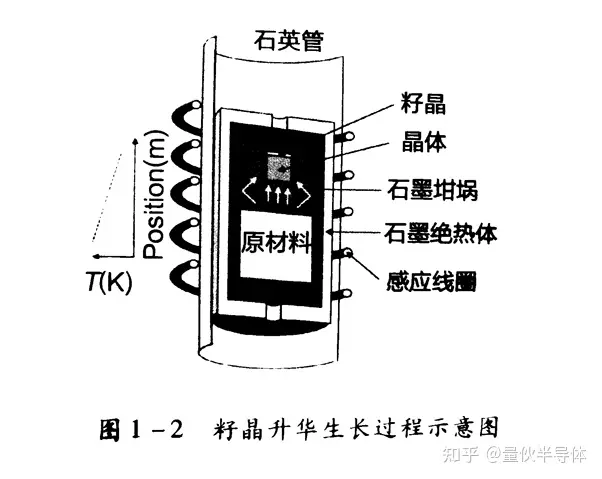
籽晶升华生长是目前业界广泛应用的标准工艺,关键点是石墨坩埚的温度分布设计及气体浓度控制的精度。
2、 高温化学气相沉积(HTCVD)
物理气相传输技术在当今的碳化硅衬底生产中占主导地位,该生长系统基于一个立式的反应器,在反应腔体内把反应的前体(如SiH4和C2H4)在载气中稀释,然后通过加热区向上送入籽晶容器。
3、 卤化物化学气相沉积(HCVD)
卤化物化学气相沉积从经典的化学气相沉积发展而来,是在高温下生成碳化硅的工艺,用于薄层和厚层的沉积,是纯化学技术,但是后续未得到进一步发展。
4、 改良版的物理气相传输(M-PVT)
从技术上讲,此技术的重要性在于提供了一种连续进料掺杂的可能性,并且可以改善掺杂均匀性,但是该工艺尚未有进一步发展。
5、 连续进料物理气相传输(CF-PVT)
连续进料物理气相传输的优势是结合了单晶生长的物理气相传输和高温化学气相沉积的连续相,可以连续提供高纯度多晶碳化硅源。可以实现特定的过饱和控制,这是生长几毫米厚的大块3C-SiC单晶的唯一工艺。
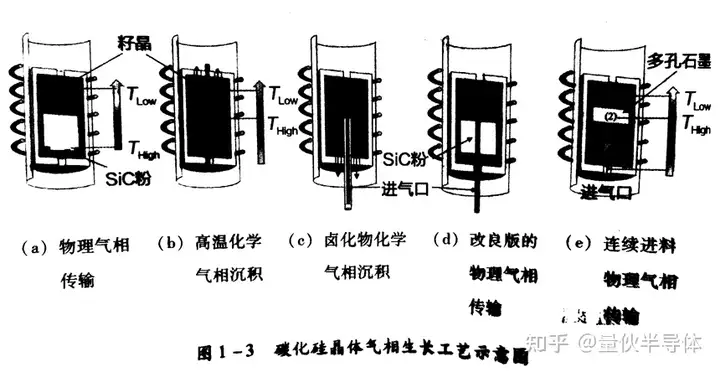
6、 顶部籽晶液相生长(TSSG)
顶部籽晶液相生长是一项晶体生长提拉技术与助溶剂生长方法的重大发展,该技术通常在高温溶液中进行碳化硅的生长,产生的错位密度低于其他方法,60多年前人们就尝试使用这个方法,直到近期才有突破进展,成功生长出了碳化硅单晶晶体。缺点是生长速率极慢,不适用于大规模的产业应用。
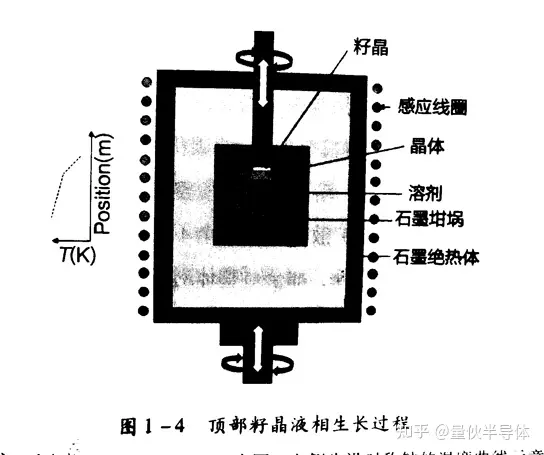
目前碳化硅的缺陷:
在过去20多年中,碳化硅晶体的质量有了很大提高。但无论是单晶碳化硅衬底还是外延层的生长,仍然有各种缺陷。对碳化硅器件的性能和可靠性产生了不同程度的影响。在4H-SiC的单晶生长和外延生长中,其物理缺陷主要包括结构缺陷和表面缺陷。结构缺陷主要存在于外延层中,包括微管(MP),螺旋位错(TSD)和基矢面位错(BPD);表面缺陷包括三角形凹坑、生长坑和胡萝卜凹槽。碳化硅中的高密度缺陷主要是螺旋位错、基矢面位错、刃型位错(TED)和堆垛层错(SF)等。
其中,碳化硅晶体中的高密度缺陷主要以螺旋位错和基矢面位错对器件的影响最大,因此必须将其密度降低到一定水平,才能确保器件可靠运行。
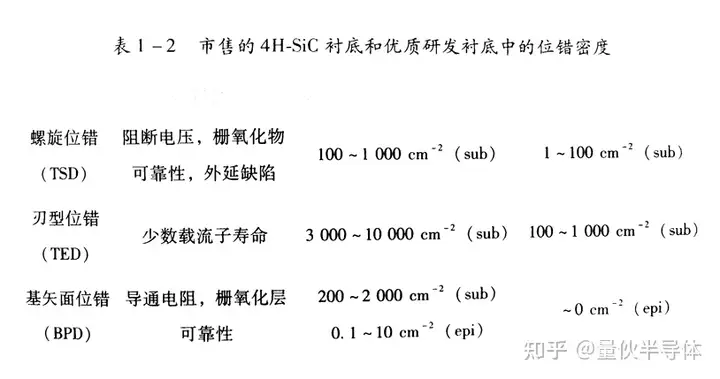
高温退火工艺利用
重掺杂氮的4H-SiC晶体在超过1273K温度的高温处理过程中会发生结构变化。这种结构变化归因于4H到3C晶型的转变,这是由高温退火期间双层Shockley型层错(DSSFs)的形成和扩展引起的。近来,关于重掺杂氮的4H-SiC晶体中形成DSSFs有了一系列新发现,比如在1423K的温度下退火,整体电阻率呈各向异性的增长,当退火温度继续升高,达到2073K的温度时,增加的电阻可以部分恢复,即部分下降。其中二极管的SSSFs通过低温(483-873K)退火反而逆向生长,与在重掺杂氮的材料中观察到的结果相似,SSSFs的收缩也与电阻率的恢复有关。

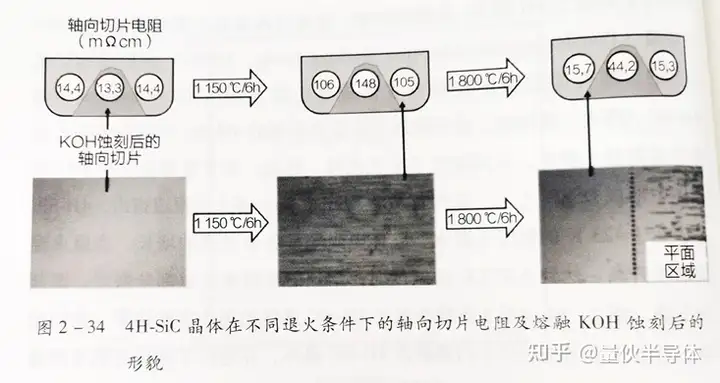
碳化硅外延工艺:
对所有碳化硅电子器件的制造而言,必须首先在碳化硅衬底上进行外延薄膜的生长,因为在衬底中无法进行扩散掺杂,且若在其中直接注入离子,会导致碳化硅的电气质量较差。由于同质外延生长的碳化硅薄膜具有出色的电气特性,目前几乎所有的碳化硅高性能器件都使用这种外延薄膜制造。
碳化硅薄膜的的同质外延生长可以通过各种方式实现,如气相外延(VPE)、液相外延(LPE)、气液固外延(VLS),后者是最近引入的外延制造方法,是VLS纳米线和纳米管生长的共同基础。
引用:姚玉、洪华主编【第三代半导体技术与应用】



